Die heutigen Anforderungen an Haltbarkeit und Zuverlässigkeit machen eine lückenlose Aushärtung zu einer Notwendigkeit.
Probleme, die durch Voids verursacht werden
- Verminderte Haftung des Bauelements am Substrat
- Verminderte thermische Leistung
- Elektrische Ausfälle durch "Lötfehlstellen"
- Geringere Zuverlässigkeit und kürzere Lebensdauer+
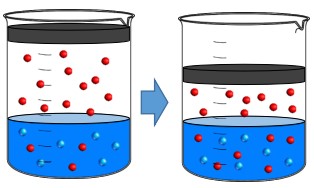
Druckhärtung beseitigt Voids
Je höher der Druck, desto mehr Gasmoleküle können sich auflösen (Henry'sches Gesetz)
- Henry's Law - Die Menge des gelösten Gases in einer Flüssigkeit ist proportional zu seinem Partialdruck über der Flüssigkeit.
- Durch die Erhöhung des Drucks während des Aushärtungsprozesses werden Hohlräume beseitigt.
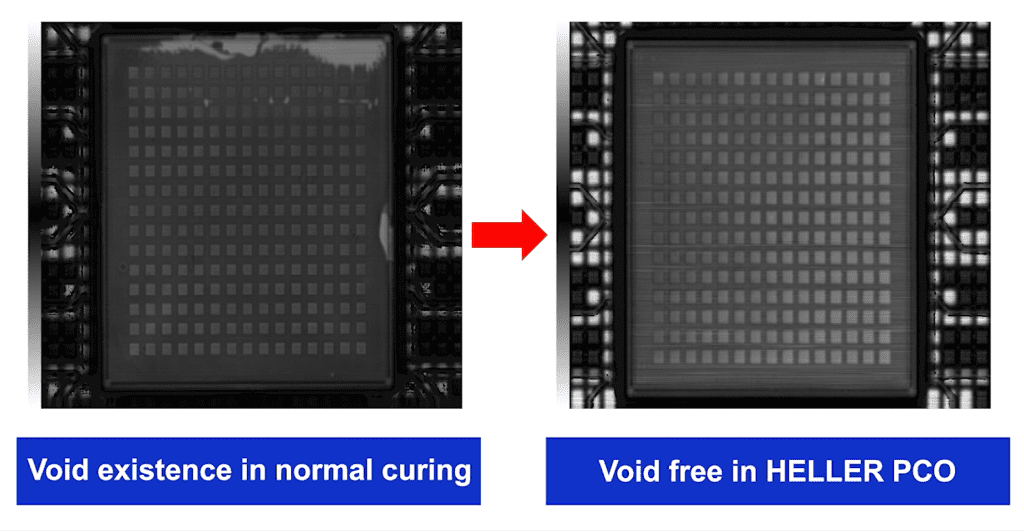
Prozess der Druckhärtung im Ofen
- Ein Druckaushärteofen (PCO) oder Autoklav wird zur Minimierung von Hohlräumen und zur Erhöhung der Haftfestigkeit bei einer Vielzahl von Klebe- und Aushärtungsanwendungen eingesetzt.
- Ein PCO setzt eine starre Kammer mit Luft oder Stickstoff unter Druck und hält während des Aushärtungszyklus ein Druckprofil aufrecht, das durch die Rezeptur festgelegt ist.
Konvektionsheizungen und Wärmetauscher sorgen während des gesamten Aushärtungszyklus für ein nach Rezept definiertes Wärmeprofil.

Eine typische PCO-Temperatur- und Druckprofil.
Typische PCO-Anwendungen
- Die Attach Aushärtung
- Underfill-Härtung
- Ag-Sintern Aushärtung
- MEMS-Versiegelung
- Gurtung/Laminierung
- PCB-Via-Füllung
- Verkapselung Aushärtung
- Verbundwerkstoff-Formung

Leader in Thermal Process Solutions



